Pokročilé termálne modely výkonových komponentov
Konštrukcia moderných, stále výkonnejších a pritom menších zariadení vynáša do popredia technické problémy, ktoré boli donedávna považované za okrajové. Jednou z takýchto oblastí je tepelný manažment navrhovaného zariadenia, keďže teplota predstavuje významný faktor ovplyvňujúci životnosť zariadenia. Na obr. 1 môžeme vidieť, že teplota komponentov predstavuje najvýznamnejší faktor spôsobujúci poruchy aj v takých náročných aplikáciách, ako je automobilová elektronika. V kancelárskych a domácich aplikáciách, kde nehrajú významnú rolu vibrácie a vlhkosť, takisto prašnosť je významne nižšia, je teplota komponentov prakticky jediným faktorom ovplyvňujúcim životnosť zariadenia.

Súčasný trend integrácie so sebou prináša nárast výkonovej hustoty, pričom novovyvíjané komponenty vzhľadom na použitú technológiu sú stále citlivejšie na zvýšenú pracovnú teplotu. Ako príklad môžeme uviesť svetelné zdroje, ktoré v súčasnosti prechádzajú na LED zdroje. Účinnosť týchto zdrojov je síce vyššia, no ich pracovná teplota musí byť nižšia. Kým klasická žiarovka pri príkone 100 W vyžarovala 5 W svetelného výkonu, 12 W tepelného výkonu a zvyšných 83 W vo forme IČ žiarenia, LED zdroj s podobným svetelným výkonom 5,1 W produkuje 11,9 W odpadového tepla. Vyššia účinnosť tohto typu svietidiel je teda daná nižšou pracovnou teplotou, z čoho vyplýva aj absencia IČ zložky. Odvrátenou stranou zvýšenej účinnosti je fakt, že kým pracovná teplota žiarovky bola obmedzená len tepelnou odolnosťou okolia, pracovná teplota LED čipu musí byť udržiavaná na minimálnej hodnote. Každé zvýšenie teploty čipu o 10 °C skracuje životnosť na polovicu. Ideálne by sa pracovná teplota LED čipu mala pohybovať do 90 °C, v prípade moderných výkonových svetelných zdrojov až do 120 °C.
Hlavným spôsobom odvodu odpadového tepla vzhľadom na nízke pracovné teploty je vedenie cez DPS na chladič (obr. 2). Pre simuláciu tepelných pomerov s týmto typom výkonových komponentov sú v súčasnosti využívané 2R alebo pokročilé DELPHI termálne modely (obr. 3). Tieto modely vďaka svojej komplexnosti dobre opisujú cesty odvodu tepla z čipu paralelnými cestami cez chladiace nosníky, vývody a materiál puzdra.
Elektronické zariadenia súčasnosti však spravidla pracujú v spínanom režime. Priebeh termálnej expozície čipov má dynamický charakter, teda používané modely pre stacionárne zaťaženie prestávajú vyhovovať. Pre dynamické namáhanie je potrebné zvážiť aj tepelné kapacity jednotlivých prvkov tepelnej cesty (obr. 4). Pre tieto prípady je potrebné zvažovať skutočnosť, že teplota v jednotlivých uzloch tepelného modelu nie je konštantná, ale v čase premenlivá. Rovnako je nutné brať do úvahy fakt, že rýchlosť šírenia teploty je konečná. Na obr. 5 je ukážka rozloženia teploty v okolí výkonového čipu v čase 1 sekunda a 1 minúta.
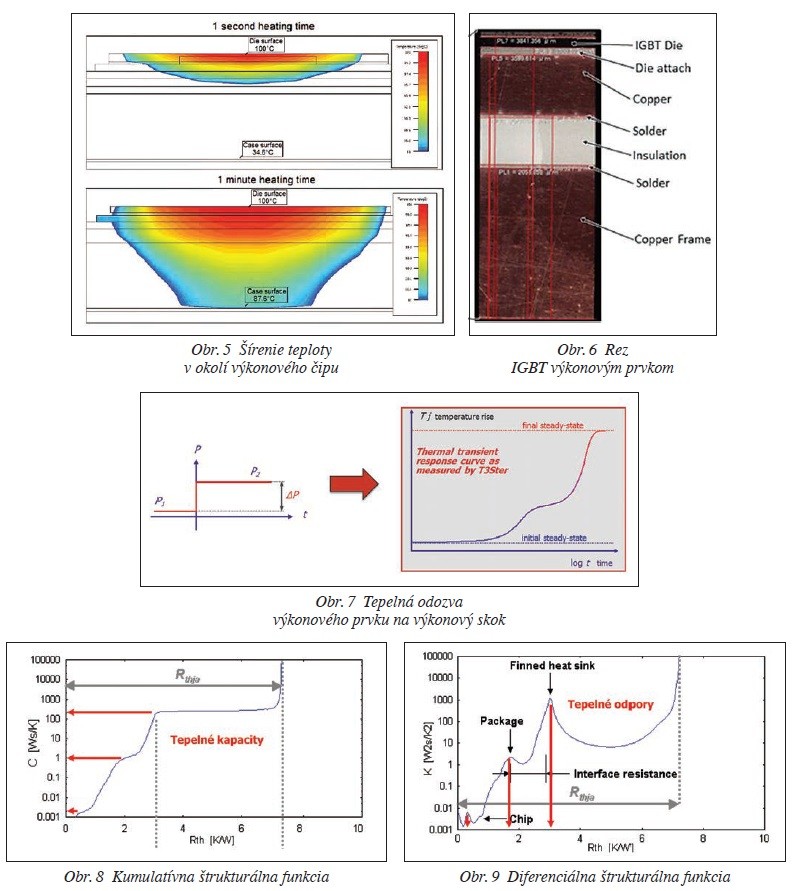
Pri simulácii výkonovej elektroniky pri dynamickom namáhaní v meničoch, budičoch motorov a podobne je teda potrebné brať do úvahy nielen tepelné vodivosti, ale aj tepelné kapacity jednotlivých konštrukčných prvkov. Moderné vysokovýkonné polovodičové prvky sú spravidla umiestňované na DBC substrát, ku ktorému sú prispájkované (obr. 6). Na dynamické tepelné vlastnosti sendvičovej štruktúry významne vplývajú aj hrúbka medenej vrstvy medzi čipom a DBC substrátom, hrúbka a druh použitej spájky a v neposlednom rade aj hrúbka samotného čipu.
V prípade znalosti presných geometrických rozmerov a fyzikálnych vlastností použitých materiálov je možné vytvoriť podrobný fyzikálny model štruktúry, ktorý umožní veľmi presné simulácie tak v stacionárnej, ako aj v dynamickej oblasti. Takýto typ modelu však kladie vysoké nároky na výpočtový výkon a jeho presnosť je determinovaná znalosťou potrebných vstupných veličín.
Z praktického pohľadu je pre simulácie lepšie vytvoriť špecializovaný model optimalizovaný na základe merania. Takýto model je možné vytvoriť z menšieho počtu R-C prvkov, čím sa významne zníži výpočtová náročnosť. Meraním je zároveň zabezpečená dobrá zhoda modelu so skutočnými súčiastkami, bez potreby získavania spravidla utajovaných informácií o vnútornej štruktúre.
Spôsob, ako merať dynamické vlastnosti impedančnej siete, je v princípe známy už dlho. Je to meranie odozvy na jednotkový skok. Z praktického uhla pohľadu ide o meranie teploty výkonového čipu po jeho skokovom zaťažení (obr. 7). Z časového priebehu nárastu teploty je možné určiť tepelné vodivosti a tepelné kapacity jednotlivých častí tepelnej cesty.
Realizovať takéto merania umožňuje napríklad prístroj T3Ster od společnosti Mentor Graphics. Prístroj umožňuje napájať výkonový čip alebo riadiť výkonnejší napájací zdroj, pričom meria teplotu na 1 až 8 miestach s rozlíšením 0,01 °C a časovým krokom 1 μs. Súčasťou systému je softvér na spracovanie nameraných dát a optimalizáciu modelov v simulačných softvéroch rovnakého výrobcu. Nameraný priebeh je možné transformovať na integrálnu (obr. 8) a diferenciálnu (obr. 9) štrukturálnu funkciu, z ktorých je možné jednoducho určiť tepelné odpory a tepelné kapacity jednotlivých častí tepelnej cesty. Toto meranie a následné vyhodnotenie tepelných odporov je možné využívať aj na nedeštruktívne testovanie výkonových prvkov pri ich montáži alebo pri pravidelných revíziách zariadenia. Prípadné únavové trhliny v štruktúre sa prejavia zvýšením tepelného odporu. Z diferenciálnej štrukturálnej funkcie je možné lokalizovať miesto poruchy a posúdiť jej rozsah.
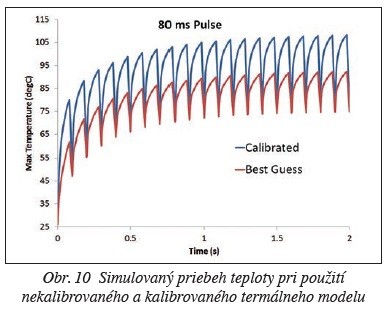
Optimalizáciou modelu na základe merania získa návrhár vyššiu presnosť, čo mu umožní lepší návrh zaradenia bez nebezpečenstva poddimenzovania (obr. 10) či predimenzovania chladenia následkom nepresných predpokladov.
Literatura
[1] Gang Wang: Thermal Testing of an Automotive LED Fog Light using MicReD T3Ster and TeraLED. Engineering EDGE Vol05, Issue 02, 2016
[2] Mathew Clark: Guide to Understanding Power Cycling. Engineering EDGE Vol04, Issue 01, 2015
[3] Mohammed Amir Eleffendi, Li Yang, Pearl Agyakwa, Mark Johnson: Quantification of Cracked Areas in the Thermal Path of High-power Multi-chip Modules using MicReD Power Tester® 1500A. Engineering EDGE Vol05, Issue 01, 2016




