Každý vlastník osobního počítače si po pár letech a někdy i měsících od koupě nevyhnutelně uvědomí rychlost pokroku v elektronice. Pracovní frekvence procesoru, kapacity paměťových čipů rostou přímo závratným tempem. Tyto parametry jsou velmi úzce spjaty s rozměry aktivních prvků (tj. zejména tranzistorů) v integrovaných obvodech. Masové využívání mikroelektronických aplikací a snaha o co nejlepší parametry stimuluje hon za stále menšími rozměry elektronických součástek a obvodů. Rozměry tranzistorů v dnes komerčně vyráběných integrovaných obvodech již překročily magickou hranici 100 nanometrů. Ocitli jsme se v oblasti označované jako nanotechnologie. Mezi hlavní přednosti aplikace nanotechnologií v elektronice (nanoelektronice) patří řádově vyšší pracovní frekvence a hustota integrace při nižší měrné spotřebě a výrobní ceně. Technologie tzv. vertikálních nanometrových struktur je dnes již velmi dobře zvládnutá a metody jako molekulární epitaxe – Molecular Beam Epitaxy (MBE), a organokovová epitaxe – Metalo- Organic Vapour Phase Epitaxy (MOVPE) umožňují vytvářet polovodičové vrstvy s tloušťkou menší než 1 nm. Podstatně obtížnější je vytváření horizontálního členění struktur. Od počátku výroby integrovaných obvodů se pro přenesení požadovaného motivu na polovodičovou desku používá optická litografie, pracující na principu obdobném fotografické metodě osvěcování přes negativ neboli masku.
Litografie včetně následného leptání reprezentuje podstatnou část technologických operací při výrobě integrovaných obvodů. Rozhoduje tak podstatně o ceně výsledného produktu. Litografie se využívá k tvarování polovodičových, izolačních a kovových součástí budoucího integrovaného obvodu. Požadovaný motiv se vysvícením přes fotolitografickou masku přenese do fotocitlivé vrstvy (fotorezistu), který je nanesen na povrchu polovodičového substrátu. V případě negativního fotorezistu dojde po ozáření k polymeraci a tím k jeho zpevnění. Neozářené části fotorezistu jsou následně odleptány. Při použití pozitivního fotorezistu jsou naopak polymerní řetězce při ozáření narušeny a odstraňuje se tak ozářená část. Pro nanotechnologie je pozitivní fotorezist vhodnější, protože lépe zachovává svůj tvar. Negativní fotorezist díky polymeraci mírně zvětšuje svůj objem.
V současné fotolitografii se používá projekční expozice se zmenšením výsledného obrazu v poměru 1 : 4 až 1 : 10. Výhodou je přiměřené zmírnění požadavků na masce. Zmenšený obraz pokryje jen část povrchu substrátu, proto se využívá opakovaných expozic krokovacím zařízením.
Chceme-li vytvářet jemné detaily nanometrových rozměrů, stává se omezujícím faktorem vlnová délka použitého světla. Menší struktury není možné zobrazit díky difrakci na úzkých štěrbinách, které maska obsahuje. Proto výrobci používají ultrafialové světlo se stále kratší vlnovou délkou. Namísto pásů g a i rtuťového emisního spektra se nejprve začala využívat vlnová délka 248 nm – z oblasti hlubokého ultrafialového spektra (DUV). Masky a optika pro DUV litografii musí být z křemenného skla, které je pro tuto vlnovou délku průhledné. Připravuje se přechod na vlnovou délku 157 nm. Pro oblast 157 nm křemenná optika již průhledná není. Optické díly se proto musí vyrábět z fluoridu vápenatého. Zdrojem záření v této oblasti jsou pulzní excimerové lasery. Aktivní prostředí v optickém rezonátoru laseru tvoří plynová náplň kryptonu nebo argonu a fluoru. K dalšímu zlepšení rozlišení DUV fotolitografie se používají následující metody: Optical Proximity Correction (OPC) spočívá v úpravě fotolitografické masky zejména v rozích obrazců tak, aby bylo minimalizováno výsledné zkreslení. V konvexních rozích je motiv podexponován a v konkávních naopak přeexponován.
Metoda Phase Shift Masks (PSM) využívá masky o tloušťce odpovídající čtvrtině vlnové délky použitého záření. Zkreslení je zmenšeno díky destruktivní interferenci difraktovaných paprsků.
Dalšího vylepšení je možno dosáhnout použitím tzv. imerzní fotolitografie. Mezera mezi povrchem substrátu a optikou fotolitografického zařízení je vyplněna kapalinou s vyšším indexem lomu. S nasazením imerzní fotolitografie se počítá od 45 nm výrobní technologie.
Mezi další „triky“ patří metoda dvojitého ozáření fotorezistu – Double Exposure (DE) nebo použití projekčních kamer s užitím koherentního záření nebo s vyoseným světelným zdrojem – Off Axis Illumination (OAI). Zavedením výše uvedených korekcí a úprav projekčních zařízení je možné dosáhnout rozlišení poloviny a špičkově až třetiny vlnové délky použitého záření.
Rozlišení hluboko pod 100 nanometrů však vyžaduje další technologický posun. Ve vývoji jsou tzv. litografie nové generace – New generation Lithography (NGL), kam patří litografie využívající expozici pomocí záření z extrémní UV oblasti – Extreme Ultraviolet (EUV) o vlnové délce 13,5 nm, generovaného z xenonového plasmatu excitovaného výkonovým laserem. EUV litografie je stále ve vývoji a před jejím komerčním nasazením pro výrobu čipů bude nutné vyřešit řadu technických problémů. EUV litografie vyžaduje ultravysoké vakuum, protože záření o této extrémně krátké vlnové délce je pohlcováno plyny. Dalším problémem je, že není možno nalézt materiál pro přípravu čoček v EUV oblasti. Je nutné použít reflexní optiku. EUV záření je na substrát zaměřováno přes složitý systém zrcadel a reflexní masky (obr. 1). S uvedením EUV litografie se počítá u technologie s rozlišením 22 nm. Rentgenová (RTG) litografie – X-ray Litography (XRL) využívá záření s ještě kratší vlnovou délkou, typicky kolem 1 nm. Pro tuto oblast již neexistuje vhodná zobrazovací optika. Je tedy nutné použít tzv. kontaktní osvit, kdy maska leží na fotorezistu. Aby nedocházelo k poškození masky používá se tzv. proximitní uspořádání, kdy je mezi maskou a fotorezistem úzká mezera (obr. 2). Detaily na masce musí mít minimálně takové rozlišení, jaké je požadováno ve výsledném obrazu. Dalším problémem je zajištění dostatečného kontrastu při zachování přijatelné transmise RTG záření a finanční náročnost kvalitních zdrojů měkkého RTG záření (synchrotrony).
![Obr. 1 Schéma EUV litografie [1]](/getFile/id:5008/Obr. 1 Schéma EUV litografie [1].jpg)
Obr. 1 Schéma EUV litografie [1]
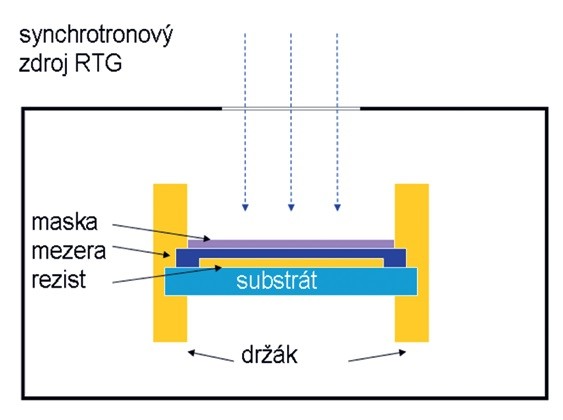
Obr. 2 Schéma RTG litografie
Snaha snížit výrobní náklady odstraněním výroby drahých masek vedla k vývoji tzv. bezmaskové optické litografie – Mask Less Lithography (MLL). Masky jsou zde nahrazeny mikroskopickými elektromechanickými systémy (MEMS). Ekonomického efektu se dosahuje zejména u malosériové výroby. Tato metoda se uplatní zejména u projekční elektronové litografie. Systém elektronových paprsků je selektivně vychylován maticí mikroelektrod v zatemňovací desce, které jsou řízeny generátorem obrazců. Vychýlený paprsek je pak zachycen a nepřispívá k expozici rezistu (obr. 3). Tím jsme se dostali k litografii elektronovým svazkem – Electron Beam Lithography (EBL). V současnosti se používá úzký svazek elektronů s tvarovanou stopou, který je využit pro přímou expozici rezistu na povrchu vzorku. Dosažitelné rozlišení závisí hlavně na energii elektronů ve svazku. Při urychlovacím napětí 5 až 30 kV lze dosáhnout rozlišení pod 10 nm. Zdrojem elektronů je wolframová katoda nebo autoemisní katoda. Komerčně se elektronové litografy používají především k výrobě masek pro RTG litografii. Podobnou bezmaskovou metodou je iontová litografie – Focused Ion Beam Lithography (FIB). Tato metoda používá namísto svazku elektronů svazek iontů. Obě mají nevýhodu v malé výrobní kapacitě zařízení uváděné v počtu exponovaných polovodičových desek za hodinu – Wafer per Hour (WPH) (obr. 4 a 5). Úzký svazek elektronů nebo iontů musí postupně oskenovat celou plochu desky.
![Obr. 3 Schéma elektronové bezmaskové litografie [2]](/getFile/id:5010/Obr. 3 Schéma elektronové bezmaskové litografie [2].jpg)
Obr. 3 Schéma elektronové bezmaskové litografie [2]
![Obr. 4 Vývoj výrobní kapacity a ceny litografických systémů [3]](/getFile/id:5011/Obr. 4 Vývoj výrobní kapacity a ceny litografických systémů [3].jpg)
Obr. 4 Vývoj výrobní kapacity a ceny litografických systémů [3]
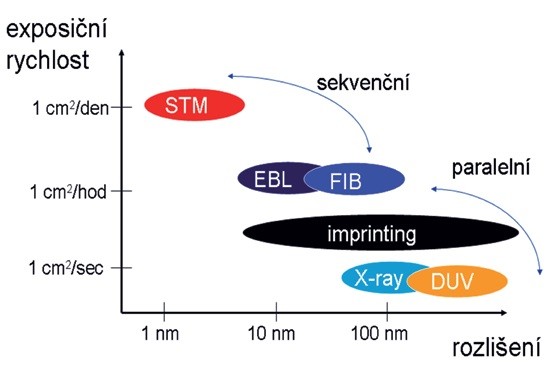
Obr. 5 Exposiční rychlost vs. rozlišení litografických metod
Nově vyvíjená metoda nesoucí název projekční elektronová litografie spojuje možnosti velmi vysokého rozlišení s vyšší průchodností, důležitou pro hromadnou výrobu. Náhrada elektronů urychlenými ionty v projekční iontové litografii umožňuje navíc dotovat a nebo jinak modifikovat povrch substrátu.
Kromě výše uvedených litografických metod se objevují nové metody využívající přímého kontaktu razítka nebo hrotu s povrchem. V současnosti se používají dva základní postupy nanometrového „tisku“: První spočívá v tvarování tenké polymerní vrstvy pomocí „tiskátka“ za zvýšené teploty a tlaku (imprinting). Druhý je založen na přenosu monovrstvy samouspořádaných molekul na substrát pomocí pružného razítka (inking). V tzv. flash imprint lithografii (obr. 6) je použito transparentní tiskátko a polymer je místo vysoké teploty vytvrzen pomocí UV záření. V posledních letech je zejména v oblasti výzkumu populární metoda litografie pomocí hrotu mikroskopu atomárních sil – Atomic Force Microscope (AFM) nebo skenovacího tunelového mikroskopu – Scanning Tunneling Microscope (STM). Ostrý hrot se zakřivením v řádu jednotek nanometrů je možno použít k vykreslování obrazců v měkkém fotorezistu a nebo k přímému rytí do povrchu polovodičové struktury. Úspěšná je metoda lokální anodické oxidace – Local Anodic Oxidation (LAO) (obr. 7), kdy je na vodivý hrot přivedeno záporné napětí vůči vodivému povrchu substrátu. Při vysoké relativní vlhkosti se na povrchu vytvoří tenká vrstva vody a pod hrotem probíhá prostorově lokalizovaná oxidace. Tato metoda je pro výzkumné účely dobrou alternativou extrémně nákladných nanolitografických metod.
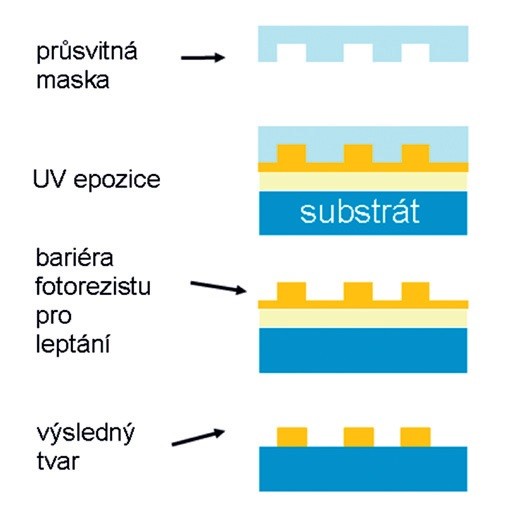
Obr. 6 Schéma flash imprintingu
![Obr. 7 Schéma lokální anodické oxidace [4]](/getFile/id:5014/Obr. 7 Schéma lokální anodické oxidace [4].jpg)
Obr. 7 Schéma lokální anodické oxidace [4]
Z nastíněného je zřejmé, že na vývoj litografických metod je ve světě vynaloženo obrovské úsilí. Přesto nelze v nejbližších letech v komerčních systémech očekávat dostatečnou rozlišovací schopnost pro detaily menší než 10 nm. Zlom by mohla přinést radikální změna přístupu. Od metody „top-down“, kdy je litograficky opracováván velký homogenní materiál k metodě „bottom-up“ využívající schopnosti samouspořádání zejména u organických molekul. Velkou pozornost vědců přitahují zejména tzv. uhlíkové nanotrubky, tvořené pravidelnými válcovými uhlíkovými makromolekulami a zcela nově v rovinném uspořádání ve formě tzv. grafénu, za jehož přípravu a studium byla v roce 2010 udělena Nobelova cena fyzikům Geimovi a Novoselovi. Jako další perspektivní materiály se schopností samouspořádání se jeví organické molekuly peptidů a molekuly na bázi DNA. Výzkumem možných aplikací těchto materiálů v elektronice se zabývá tzv. molekulární elektronika – věda na pomezí elektroniky, chemie a biologie.
[1] Wurm, S., Kemp, K., SEMATECH pushes extreme UV lithography forward, SPIE Newsroom, 2006, http://spie. org/x8865.xml?ArticleID=x8865
[2] Klein, Ch., et al., Progress in projection maskless lithography, SPIE Newsroom, 2008, http://spie.org/ x19638.xml?ArticleID=x19638
[3 Suzuki, K., Smith, B.W, Microlithography, Science and Technology, 2. vyd., CRC Press 2007
[4] Voves, J., Cukr, M., Novák, V. The AFM LAO lithography on GaMnAs layers, Microelectronic Engineering, 2009, sv. 86, str. 561–564